Privacy Policy Update
Click here to learn about the new Privacy Policy updates from Practical Components.888-388-7808
HPWTSV-0101JY


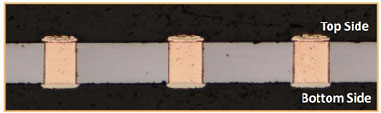
| Specifications | ||
| Base Wafer | HPW-0101JY (SiN) | |
| Wafer Thickness | 100μm | |
| Top Side | Electrode | Cu Pillar Bump |
| Number of Bump | 32 bumps + 64 Dummy bumps | |
| Bump Size | φ100μm | |
| Bump Pitch | 300μm | |
| Bump Height | Cu50μm+SnAg10μm | |
| Top Coat Layer | Passivation (P-SiN) | |
| TSV | Via Size | φ90μm |
| BottomSide | Electrode | Electroless Ni/Au plating |
| Number of Bump | 32 bumps | |
| Bump Size | φ100μm | |
| Bump Pitch | 300μm | |
| Bump Height | 8μm | |
| Top Coat Layer | P-TEOS | |


